迈向 AI 与车用新纪元:Ennostar i-Packaging™ 异质整合技术全解析
随着高效能电子装置的持续演进,传统芯片级封装已难以满足现今系统对于功率密度、散热管理、传输带宽及缩减体积的严苛要求。特别是在 AI 运算基础设施与先进智能车系统领域,效能的提升已不能单靠费时费力的单一组件改进,而必须结合既有成熟制程组件、与创新的封装整合技术来达成 。
为此,富采光电Ennostar开发了 ** i-Packaging™ ** 异质整合平台 。该平台将半导体组件视为模块化的「积木」,能弹性整合 LED、MEMS、传感器及 IC,打造出紧凑且高效能的模块,成功填补了组件创新与系统需求之间的技术鸿沟。
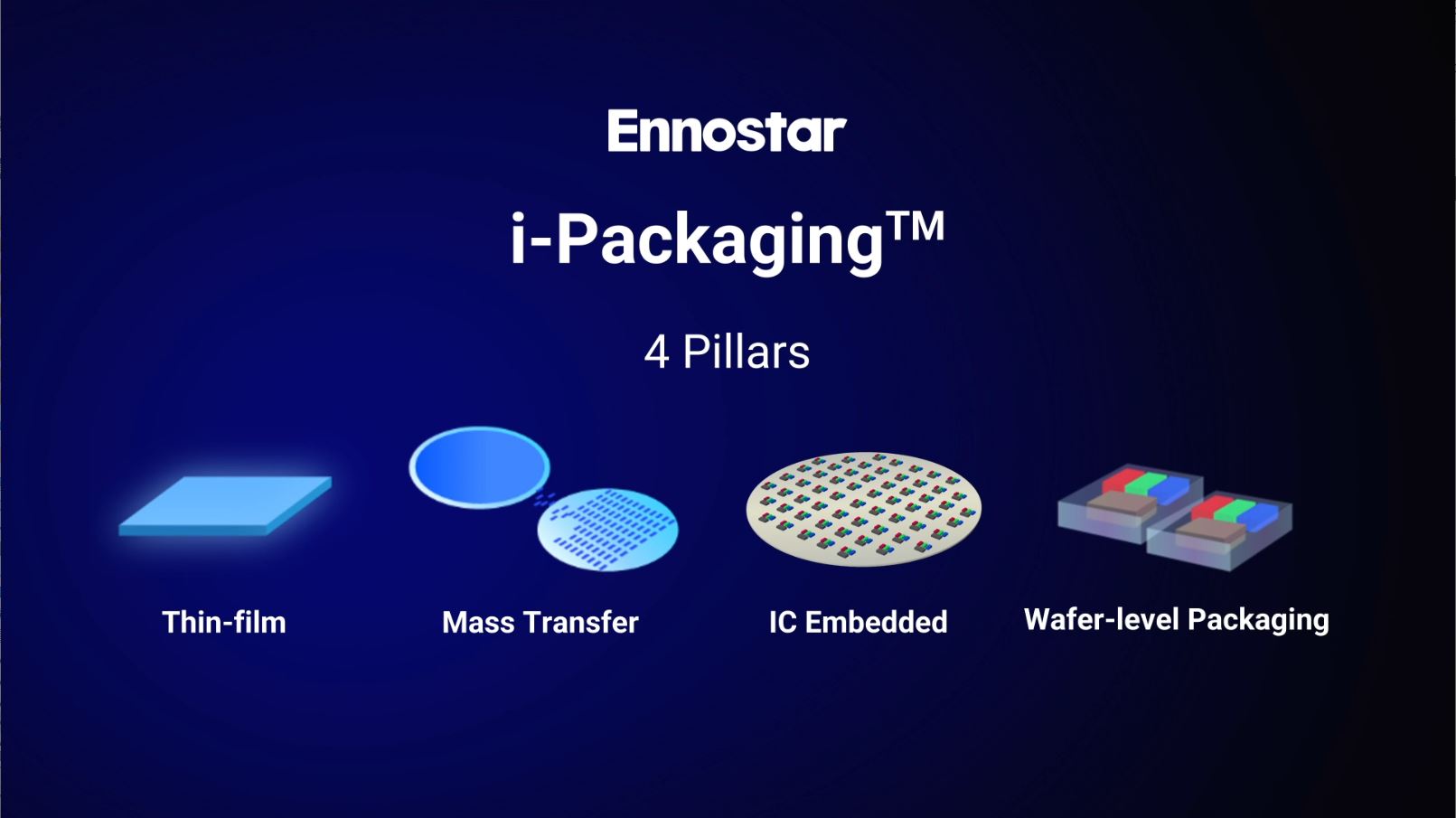
i-Packaging™ 创新的四大技术支柱
i-Packaging™ 平台由四项紧密结合的核心技术组成,共同实现可扩展、高密度的光电整合 :
薄膜技术 (Thin-Film Technology)
• 超薄整合:支持 R/G/B LED、光电接收组件(PD)、MEMS 与传感器整合,其 CoW (Chip-on-Wafer)厚度可降至 5~20 µm,即便整合多种组件,仍能极致薄化同时满足高分辨率与多功能模块的设计需求。
• 降低成本:即使不同尺寸的晶圆也能进行整合,无需额外光罩(Tape outs),有效降低开发成本 (NRE) 。.jpg)
薄膜技术:多元CoW的极致薄型化 巨量转移 (Mass Transfer)
• 精准控制:透过先进的数组与转移技术,可大量且精确维持组件间距。
• 高产能:妥善运用巨量转移技术在精度、产能与良率之间取得了最佳平衡,是大规模量产的关键。IC 嵌入式架构 (IC Embedded Architecture)
• 直接整合:将驱动、控制与感应 IC 直接嵌入封装结构中 。
• 效能优化:降低传输延迟,提升讯号完整性,并大幅简化模块电路设计。晶圆级封装 (Wafer-Level Packaging, WLP)
• 重布线层 (RDL) 技术:相较于传统 SMT 方式,提供更轻薄、完整的解决方案而不影响可制造性 。
• 高质量表现:在兼顾高分辨率与多功能模块设计下,维持高质量的光电效能 。
应用案例一:以「Slim Core」架构重塑车用照明
在车用自适应头灯 (ADB) 系统中,传统封装常面临像素间距无法进一步缩小及光学杂散效益所产生的「黄晕 (Yellow Halo)」等问题,而影响终端客户使用体验。
富采光电的 Slim Core 架构透过以下技术解决痛点:
降低黄晕:结合薄膜制程与高反射光学设计,大幅提升光束均匀度,减少黄晕产生 。

i-PackagingTM可降低 ADB 系统中的光学杂散效应与像素间距 - 高密度微型化:将像素间距从传统的 500μm 以上缩减至 50μm,实现更细腻控制的高解析光型 。
应用功能扩展:极高精度支持「像素化地面投影」,让车灯从照明工具进化为安全通讯接口,可提供如行车导航、安全警示或客制化欢迎图案 。
应用案例二:AI 数据中心的光学互连
面对 AI 运算带来的带宽与功耗挑战,i-Packaging™ 中介层 (Interposer) 为高效能光学整合提供关键支持 :
- 极致轻薄: 总厚度低于 0.1 mm,可开发极致薄型光学模块。
- 强化散热: 优异的散热表现,确保在高密度、高功率的 AI 运算环境中稳定运作。
- 光学带宽扩展能力:透过 i-Packaging™ 整合技术实现 Micro LED 数组的多任务架构,支持新世代 Co-Packaged Optics(CPO) 系统所需的高带宽密度与讯号可扩展性。
优异的精密接合良率: 采用数组优先(Array-first)制程、并结合预筛选(Pre-screening)机制,确保高精度 Micro LED 组件可稳定维持优异的接合良率。

i-PackagingTM 中介层(Interposer)的优势
结论:可扩展的未来光电平台
i-Packaging™ 平台超越了传统封装的范畴,为异质整合提供了模块化且具扩展性的基础。该平台能协助 合作伙伴在兼具性能、量产性与快速上市(Time-to-market)需求下,完成产品开发。
富采光电的 i-Packaging™ 平台,将组件创新透过异质整合的方式,达成先进与系统级需求,可广泛运用在车用照明、AI光通讯、穿戴装置、透明抬头显示器及其他智能装置,为下一代车用、先进显示、智能感测与通讯系统开辟更多未来的应用场域。

“ I-Packaging™ 架构具备通用弹性,透过灵活组合既有组件,为合作伙伴提供创新的整合路径,满足新应用于高精度/多元/快速上市的市场需求。”
现在,开始实践您的「积木式」创新构想!
i-Packaging™ 平台具备高度灵活性,是车用、AI 基础设施与智慧感测的理想技术选择。我们诚邀技术合作伙伴与我们共同开发下一代轻薄、高效的光电模块。
